総合
| 会社案内 | 会社案内パンフレット | ユーロフィンFQLの方針、サービス概要、事業所等をご紹介致します。 |
|---|---|---|
|
ソリューション |
腐食環境ソリューション | エコチェッカII、ドライガーゼ方式による塩害分析、QCMセンサなど、腐食環境測定ツールをご紹介いたします。 |
| 環境ソリューション | 腐食トラブルに関する課題に様々な側面からアプローチしたサービスです。 |


IC,半導体の故障解析手順の中で、デキャップ(樹脂開封、パッケージ開封)を行うことが頻繁に発生します。
弊社では、パッケージ封止樹脂に充填剤が多く含まれている高耐圧・大電流部品のIGBT等、パワーモジュールの樹脂開封(デキャップ)、銅(Cu)ワイヤ、銀(Ag)ワイヤなどを使用したICについて、独自に開発した手法により、ワイヤの溶解・ダメージを抑えたパッケージ開封を承ります。
| > パワーモジュール | > 銅ワイヤ品 | > 銀ワイヤ品 | > 実装基板 |
|---|
| > レーザーオープナー | > LSI回路修正 |
|---|
高耐圧・大電流部品のIGBT等のパワーモジュールには、パッケージ封止樹脂に充填剤が多く含まれているなど、樹脂開封が困難なものがあります。パッケージ樹脂を薬液等により除去し、内部観察を行い、ご要望に応じ開封後の内部部品に対して、評価/解析/分析などを行います。
※事前に開封用トライアルサンプルをご提供いただき開封可否を確認させていただきます(無償)
※IGBT(insulated-gate bipolar transistor 絶縁ゲートバイポーラトランジスタ)
大電力の高速スイッチングが可能な、パワー半導体の一種。

半導体部品の低コスト化に伴い、金(Au)ワイヤから銅(Cu)ワイヤ、銀(Ag)ワイヤへの移行が加速。後の調査に支障をきたさないよう、IC形状や解析内容に合わせダメージを抑えたパッケージ開封手法が求められます。
当社では、独自に開発した手法により、ワイヤの溶解を抑えパッケージ開封を行うことが可能です。
※開封後のワイヤ状態は、樹脂種、ワイヤ種、形状等により程度が異なります。ご希望の解析が可能か是非ご相談ください。
金ワイヤと同等の特性を持ち、ボンディング設備が流用可能な利点がある一方、薬品ダメージが大きい銀ワイヤ。
銀ワイヤへのダメージを抑えたパッケージ開封が可能です。
※日本サイエンティフィック株式会社様の飽和法による


既存のパッケージ開封方法では樹脂と共に銅ワイヤも溶解されていることが難点でした。


回路基板にLSIを搭載したままの状態で開封することが可能です。

開封前のLSI搭載状態
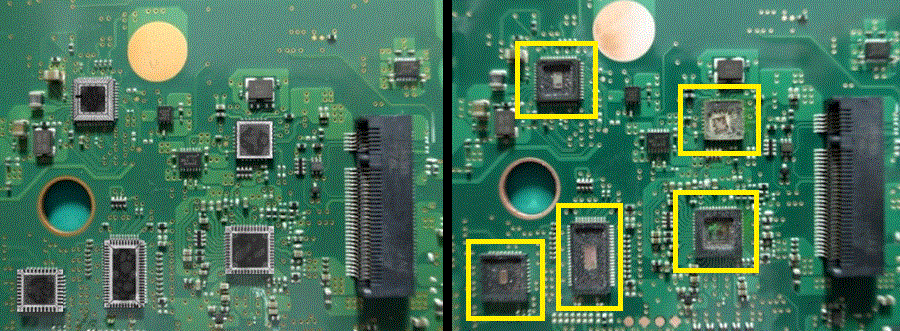
左 開封前のX線透視観察 右 対象LSIの開封状態
レーザーオープナーはチップ極限まで封止樹脂をレーザー加工により除去等を行う装置です。
・メーカー:日本サイエンティフィック
・型格:PL121


レーザーオープナー外観と庫内大きさイメージ
※ご希望の条件で試験可能かどうか、試験条件をご連絡ください。
| 項目 | 仕様 |
|---|---|
| 試料最大寸法 | W397 x D170 x H20mm |
| 加工可能領域 | 最大 50 x 50mm |
| 特徴 |
|

多層化、高集積化が進むLSI。回路加工にお困りではありませんか?
下層の微細配線の切断・接続先変更、幅広い電源配線の下層にある微細配線の加工、 動作するLSIを早急にお届けしなければならないなど、 FIBによる高品質な回路加工、配線加工サービスを提供しております。
☑ 最小試料数1個からご相談をお受けします。
☑ 多層/高集積度なLSIの下層も加工可能です。
☑ 特殊形状品/ボード搭載品(最大サイズ:12cm角)にも対応いたします。


※当サービスは、当社協力会社での実施(愛知県/お立会い可能)となります。加工技術者より直にご連絡を差し上げます。
| 会社案内 | 会社案内パンフレット | ユーロフィンFQLの方針、サービス概要、事業所等をご紹介致します。 |
|---|---|---|
|
ソリューション |
腐食環境ソリューション | エコチェッカII、ドライガーゼ方式による塩害分析、QCMセンサなど、腐食環境測定ツールをご紹介いたします。 |
| 環境ソリューション | 腐食トラブルに関する課題に様々な側面からアプローチしたサービスです。 |
こちらよりダウンロードお願いいたします(外部サイト)